碳化硅和氮化镓对半导体测试提出新挑战
在电动汽车(EV)引领时代潮流的背景下,各种新技术层出不穷以紧跟不断变化的市场需求。其中,采用碳化硅(SiC)和氮化镓(GaN)复合半导体的持续发展,便是为高性能电力系统提供解决方案的典型案例。
泰瑞达的Jeorge Hurtarte指出,新技术的发展趋势要求我们采用新的测试方法。请继续阅读,了解未来发展趋势,以及泰瑞达如何积极推动测试,及其与时俱进的测试策略。
创新测试协议以应对宽带隙材料
在众多电力应用领域,半导体行业正逐步告别硅材料,转而采用SiC和GaN等新型“宽带隙”半导体材料。与传统的硅基半导体相比,SiC和GaN凭借其独特的材料属性,不仅能够承受更高的电压和电流,还能够在更高的频率下稳定运行(见图1)。这些材料针对电力转换应用进行了优化,例如,SiC被广泛应用于电动汽车的牵引逆变器和充电站;GaN则在工业和商业电源充电器领域备受青睐。
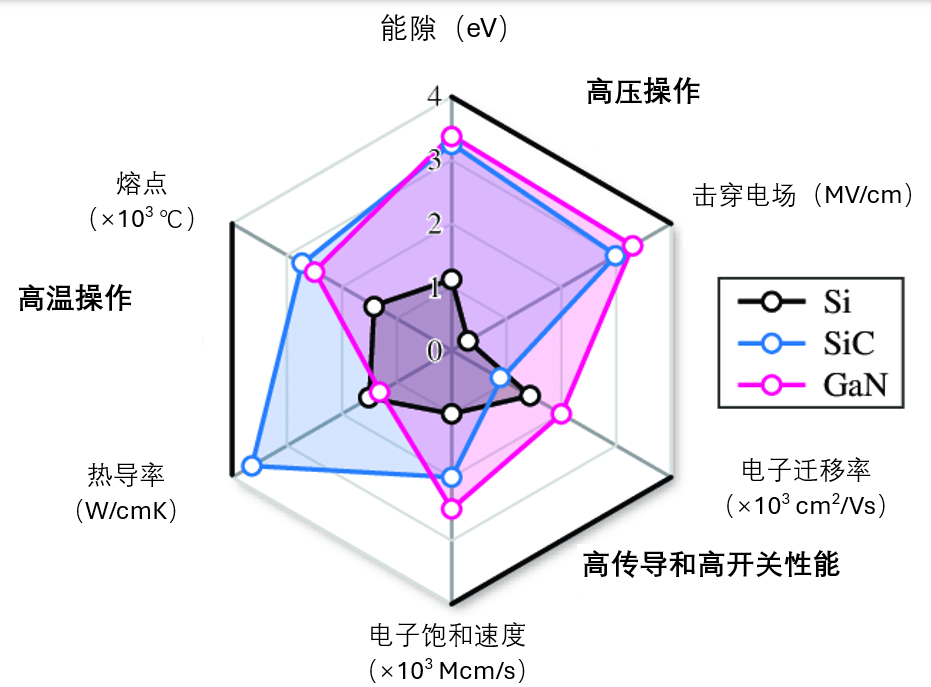
图1.此图展示了SiC和GaN相比硅的显著优势(来源:www.Researchgate.net)。
要成功测试这些芯片,就必须借助专用设备。这些设备不仅要能够安全、精准地测量极高的电压和电流水平,还需有效应对高功率测试环境所带来的一系列潜在风险。
SiC和GaN芯片还具有优异的热导率(见图1),能够在更高温度下工作。此特性虽然提升了相关器件的性能,但同时也给热测试带来了新的挑战。测试设备必须能够模拟并测量芯片在高温条件下的性能。此外,保持测试环境的一致性和可控性至关重要,这不仅能避免器件受到损害,还能确保获取可靠的性能数据。
SiC和GaN芯片具有快速开关能力,因而常用于高频应用。然而,这些芯片的动态性能测试,例如开关速度、效率和电磁干扰(EMI)测试,比硅芯片更为复杂。要想精确地表征这些参数,就需要借助先进的测试方法和设备,以便捕捉高速事件以及器件开关行为的细微变化。
SiC的晶体结构也比硅更容易出现缺陷,这些缺陷会影响器件的可靠性和性能。测试过程必须包括长时间和不同环境条件下的全面可靠性测试。因此,对碳化硅(SiC)器件进行测试以剔除裸片上的早期失效就显得尤为重要,不仅需要在晶片分割前进行,还需对分割后的单个裸片严格检验。这为客户提供了 “已知合格裸片” (KGD),这些裸片可以被封装为分立器件,或与其他裸片组合成模块。如果不进行KGD测试,那么单个不良(或性能低下)裸片可能会导致整个模块失效,这无疑会给功率模块制造商带来巨大的经济损失。
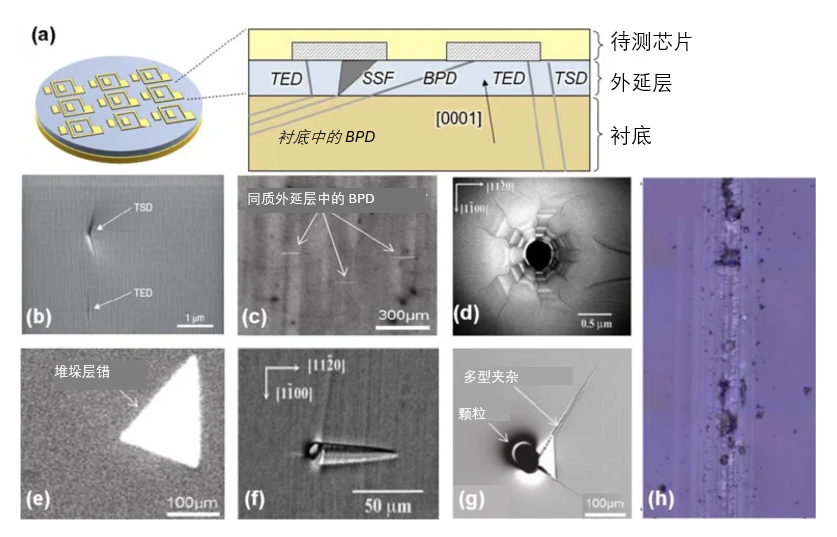
SiC衬底形成过程中通常存在大量缺陷。相比之下,硅晶圆是纯净、无缺陷的单晶衬底(来源:Chen, PC., Miao, WC., Ahmed, T. et al.Defect Inspection Techniques in SiC.Nanoscale Res Lett 17, 30 (2022). https://doi.org/10.1186/s11671-022-03672-w)。
作为测试领域的领军企业,泰瑞达扩展了ETS-88平台的功能,以支持对SiC和GaN芯片的测试工作,其中包括静态直流测试和高速开关交流测试。
利用AI优化数据和测试效率
测试碳化硅(SiC)和氮化镓(GaN)器件的整体复杂性,尤其是在预测探针磨损和管理高功率测试方面,亟需将人工智能(AI)与机器学习技术融入测试系统。例如,碳化硅测试需要使用数千伏的电压和数千安培的电流,在此过程中,AI可以用来预测接触晶圆的探针的可靠性。这可以让我们对生产状态有更深入的了解,比如可以帮助晶圆厂的生产团队预测探针将在数分钟、数小时或数天后出现磨损,从而提前备好库存以便及时更换。
为了满足这一需求,泰瑞达积极通过Archimedes分析平台整合AI和机器学习技术,从而帮助优化测试条件、预测故障,并提高测试流程的整体效率。如此一来,在测试过程中能够即刻做出调整,进而提高测试精度,提升产品良率。显而易见,市场对SiC和GaN测试解决方案的需求正有力地推动着创新。这不仅体现在更先进的测试设备上,还包括针对宽带隙半导体的特性量身定制的软件工具和诊断系统。
积极协作,迎接未来
碳化硅和氮化镓等材料正在突破传统测试方法的极限, 因此需要创新解决方案以确保测试过程的可靠性与效率。泰瑞达的ETS-88测试系统兼具高吞吐量与低测试成本的优势,可满足多种应用场景需求,成为了测试此类器件的理想之选。
在半导体市场日新月异的当下,持续创新和充分准备至关重要。唯有如此,ATE才能在复杂苛刻的开发环境中满足制造商的需求,发挥关键作用。
泰瑞达始终站在半导体测试技术创新的前沿,通过主动布局灵活高效的测试能力,为半导体封装与材料科学的最新突破提供解决方案。公司紧跟行业趋势与技术演进,致力于为客户提供丰富的工具支持,助力他们在日益复杂、竞争激烈的市场中脱颖而出,创造辉煌成就。











